制造IC的步骤和过程
集成电路芯片也称为IC或微芯片。它是一种半导体晶圆,其中制造了数百万个组件。有源和无源元件,如电阻器,二极管,晶体管等和外部连接通常在极小的单芯片硅上制造。所有电路元件和互连都是在单个薄晶圆(衬底)上形成的,称为单片IC。IC的尺寸非常小。它需要显微镜来观察组件之间的连接。制造IC芯片的步骤类似于制造晶体管,二极管等所需的步骤。在IC芯片中,晶体管、二极管、电容器等电路元件的制造及其互连是同时完成的。它具有体积极小,重量轻,成本低,功耗低,处理速度快,易于更换等优点。IC是所有电子设备中的主要元件。 IC可用作放大器,振荡器,定时器,计数器,计算机存储器等。
IC制造步骤
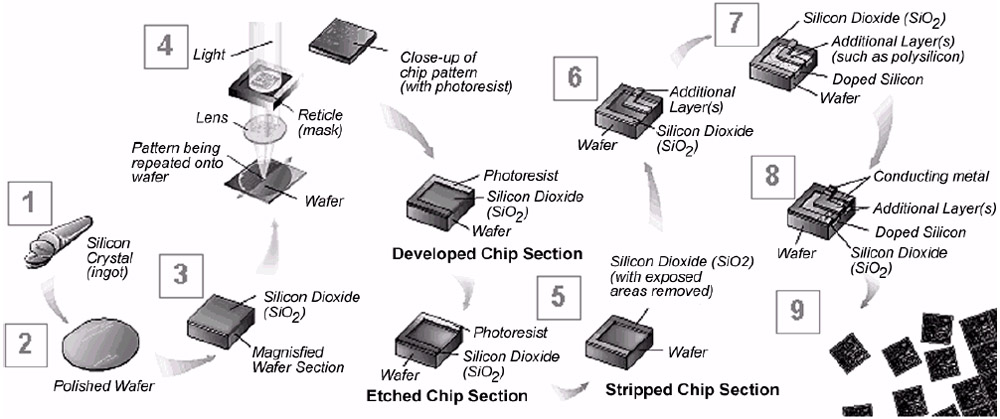
集成电路芯片的制造包括以下步骤。这些步骤包括8-20个图案化层创建到基板上以形成完整的集成电路。电活性区域是由于晶圆内部和表面上的这种分层而产生的。可以在单个薄硅上制造数百个集成电路。然后将其切割成单独的IC芯片。
步骤1硅片生产
第一步是晶圆生产。晶圆是硅等半导体材料的圆形切片。硅由于其特性而更受欢迎。它更适合制造IC。它是整个芯片的基板或基板。首先从沙子中产生纯化的多晶硅。然后将其加热以产生熔融液体。将一小块固体硅浸在熔融的液体上。然后将固体硅(种子)慢慢从熔体中拉出。液体冷却形成单晶锭。使用晶圆切片机切割薄圆形硅晶圆。晶圆切片机是一种精密切割机,每个切片的厚度约为0.01至0.025英寸。当晶圆被切片时,表面会损坏。它可以通过抛光来平滑。抛光晶圆后,必须彻底清洁和干燥。晶圆使用高纯度低颗粒化学品进行清洁。硅晶片暴露在超纯氧中。

外延生长
它意味着在原始硅衬底上生长单硅晶体。在晶圆表面形成均匀的二氧化硅层。
步骤2掩蔽
为了在晶圆的某些区域工作时保护另一个区域,使用了一种称为光刻的过程。光刻过程包括使用照相掩模和光蚀刻进行遮罩。在晶圆上涂上光刻胶膜。晶圆使用光对准器与掩模对齐。然后通过面罩暴露在紫外线下。在此之前,晶圆必须与掩模对齐。通常,有用于对齐目的的自动工具。
第3步蚀刻
它有选择地从晶圆表面去除材料以创建图案。图案由蚀刻掩模定义。材料的部件由该蚀刻掩模保护。湿(化学)或干(物理)蚀刻可用于去除未掩模的材料。为了同时在所有方向上进行蚀刻,将使用各向同性蚀刻。各向异性蚀刻在一个方向上更快。湿法刻蚀是各向同性的,但蚀刻时间控制困难。湿法蚀刻使用液体溶剂去除材料。它不适合传输具有亚微米特征尺寸的图案。它不会损坏材料。干法蚀刻使用气体去除材料。它具有强烈的各向异性。但它的选择性较低。适用于小尺寸的转移图案。剩余的光刻胶最终使用其他化学品或等离子体去除。然后检查晶圆,以确保图像从掩模传输到晶圆的顶层。
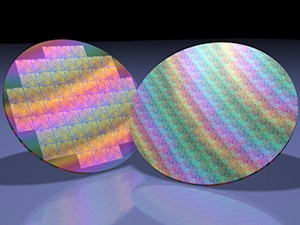
步骤4掺杂
为了改变硅的电特性,将比硅少一个电子的原子(例如硼)和具有一个电子的原子(例如磷)引入该区域。产生P型(硼)和N型(磷)以反映它们的导电特性。扩散被定义为半导体材料中杂质原子在高温下的运动。
原子扩散
在这种方法中,通过将掺杂剂添加到晶圆中来创建p和n区域。晶圆被放置在由石英组成的烤箱中,并被加热元件包围。然后将晶圆加热到约1500-2200°F的温度。 惰性气体携带掺杂剂化学物质。掺杂剂和气体通过晶圆,最后掺杂剂将沉积在晶圆上。此方法只能用于大面积区域。对于小区域,这将是困难的,并且可能不准确。
离子注入
这也是一种用于添加掺杂剂的方法。在这种方法中,掺杂剂气体如磷化氢或三氯化硼将首先被电离。然后,它向晶圆的指定区域提供一束高能掺杂剂离子。它会穿透晶圆。穿透的深度取决于光束的能量。通过改变光束能量,可以控制掺杂剂渗透到晶圆中的深度。光束电流和曝光时间用于控制掺杂剂的量。这种方法比原子扩散过程慢。它不需要掩蔽,这个过程非常精确。首先,它将晶圆指向需要的地方,并将掺杂剂射到需要的地方。
步骤5金属
它用于与硅建立联系并在芯片上进行互连。一层薄薄的铝沉积在整个晶圆上。选择铝是因为它是一种良好的导体,与硅具有良好的机械粘合,形成低电阻接触,并且可以通过单一沉积和蚀刻工艺进行应用和图案化。
制作连续层: - 对每个连续层重复诸如掩蔽,蚀刻,掺杂等过程,直到所有集成芯片完成。在组分之间,二氧化硅用作绝缘体。这个过程称为化学气相沉积。为了制作接触垫,沉积铝。制造包括由介电层隔开的三层以上层。对于电气和物理隔离,每个组件中都包围着一层固体电介质,以提供隔离。可以在同一硅衬底中制造PNP和NPN晶体管。为了避免电路的损坏和污染,最终的介电层(钝化)沉积在一起。之后,将测试单个IC的电气功能。检查晶圆上每个芯片的功能。那些未通过测试的芯片将被拒绝。
组装和包装
每个晶圆都包含数百个芯片。这些芯片通过称为划线和切割的方法分离和包装。晶圆类似于一块玻璃。金刚石锯将晶圆切成单个芯片。金刚石尖端工具用于通过分隔各个切屑的矩形网格切割线条。在电气测试中失败的芯片将被丢弃。在包装之前,在显微镜下观察剩余的芯片。然后将好的芯片安装到封装中。细线通过超声波键合连接。然后将其封装以进行保护。在交付给客户之前,芯片再次进行测试。有三种配置可用于打包。它们是金属罐封装,陶瓷扁平封装和双线封装。对于军事应用,芯片组装在陶瓷封装中。整个集成电路密封在防静电塑料袋中。
侵权必删
Please let us know if there is any infringement







